
1
N. VISUAL STANDARDS FOR CHIP CAPACITORS
EXTERNAL VISUAL STANDARDS
MLC capacitors must possess fine workmanship and physical integrity. Visual inspection of chip
capacitors involves observation of the product under 20X magnification, for major and minor de-
fects in workmanship in the capacitor body and end metallization. Visual standards are detailed in
MIL-C-123B, Appendix C, and apply to the chip body, metal terminations, chip edges, surfaces and
marking, if applicable. Typically, manufacturers inspect only sample quantities, in accordance with
MIL STD 105, Level II, 0.65. Acceptance or rejection of standard production lots is based on
various defective (AQL level or ppm level) criteria. The nature of the defects is listed in Table N-1
and depicted in Figure N-1.
Major Defects:
1. Cracks, blisters, raised surfaces or delaminations in the capacitor body.
2. Chips or voids in the capacitor body which exceed .003" (.08mm),
or which expose internal electrodes.
3. Foreign debris bonded to the chip surface, which exceeds .005" (.13mm)
4. Miscutsof the capacitor edge which penetrate the surface by more than
.005"(.13mm), or expose internal electrodes. Flared edges.
5. Termination defects:
·
Voids in the termination which expose electrodes.
·
Voids in the termination exceeding .005" (.13mm).
·
Exposed metallized edges which exceed 10% of edge dimension.
·
Bare corners on metallized ends.
Minor Defects:
1. Minor irregular cuts of sides or corners
2. Foreign debris on capacitor surface not exceeding .005" (.13mm).
3. Termination Defects:
·
Voids in metallization less than .005" (.13mm).
·
Exposed metallized edges which do not exceed 10% of edge dimension.
·
Poor marking (if applicable)
TABLE N-1
TYPICAL CRITERIA FOR VISUAL DEFECTS
NOVACAP
TECHNICAL BROCHURE
tech_visual_standards-html.html
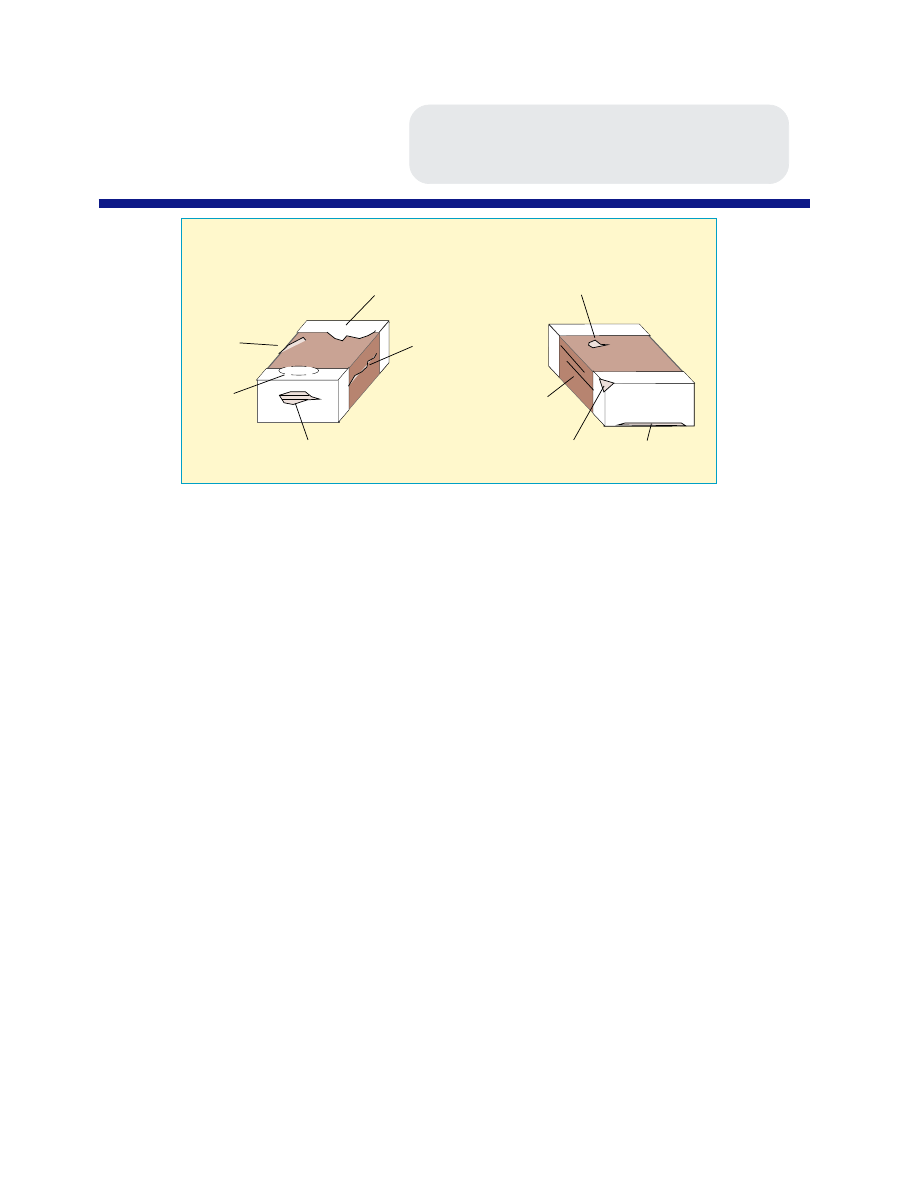
2
INTERNAL MICROSTRUCTURE STANDARDS
In addition to the external visual characteristics, quality standards for internal microstructure of the chip
capacitor are also applicable, as viewed on polished cross sections of capacitor samples. Units are
sectioned along the long and short dimension of the capacitor to provide two edge views of the internal
electrodes and terminals.
Although any degree of internal defect is considered undesirable, the fact remains that these types of
defects can occur occasionally in different degrees of severity. Typically, delaminations, internal voids,
cracks and other irregularities are classified as to their severity, and are considered to constitute defects if
they exceed the following, as based on EIA 469. (Refer also to Figure N-2.).
Delaminations
A delamination is a separation of the structural layers of the capacitor, in the form of a planar cavity,
between the electrode and ceramic, or within the dielectric itself. Any delamination which can be consid
crack
delamination
bubble
void - exposed electrode
debris
bare edge
truncated corner
exposed electrode
excessive metallization
FIGURE N-1
VISUAL DEFECTS
ered to be detrimental to the electrical and mechanical integrity of the capacitor is classified as a defect, and
generally involves the following:
• Any delamination in the active (electrode overlap) area, longer than 20% of the electrode length,
or exceeding .010" (.254 mm), whichever is greater.
• Any delamination greater than .005" (.127 mm), located within the electrode overlap area, and
associated with displacement of adjacent electrodes and reduction of these dielectric layers by
more than 50% of their thickness.
• A delamination which exceeds 50% of the margin between the termination and electrodes of
opposite polarity.
• Two or more delaminations exceeding .010” which overlap each other in the active electrode area,
in adjacent layers.
NOVACAP
TECHNICAL BROCHURE
tech_visual_standards-html.html

3
Voids
Any void which can be considered detrimental to the electrical and physical integrity of the capacitor
is classified as a defect, and generally involves the following:
Any void between electrodes of opposite polarity, which reduces the dielectric thickness by
more than 50%.
Any void in the cover plate of the capacitor which reduces the cover thickness to less than .003"
(.076 mm), or less than the active dielectric thickness.
A void or bubble in the termination ,not contacting the dielectric surface, which exceeds
30% of the chip end dimension.
A void or bubble in the termination, contacting the dielectric, which exceeds .020" (.508
mm).
Cracks
Any crack which can be considered detrimental to the electrical and physical integrity of the capaci-
tor is classified as a defect, and generally involves the following:
Any crack connecting any two electrodes.
Any crack connecting an electrode to any exterior surface of the chip, or to a termination.
Cracks extending from the termination metal band into the interior of the chip (termination
stress crack).
Non-Uniformities
Irregularities in the construction of the chip capacitor do not necessarily affect the mechanical or
electrical integrity of the device, but may be of concern in high reliability applications. The following
is a compilation of structural irregularities according to the EIA 469:
A side or end margin of dimension less than .003" (.076 mm) between 90% or more of the
electrodes and the exterior dielectric surface.
Ceramic cover plate thickness which is less than the dielectric thickness between adjacent
electrodes.
Variations in the active dielectric layers which result in areas with less than 50% of the nominal
NOVACAP
TECHNICAL BROCHURE
tech_visual_standards-html.html
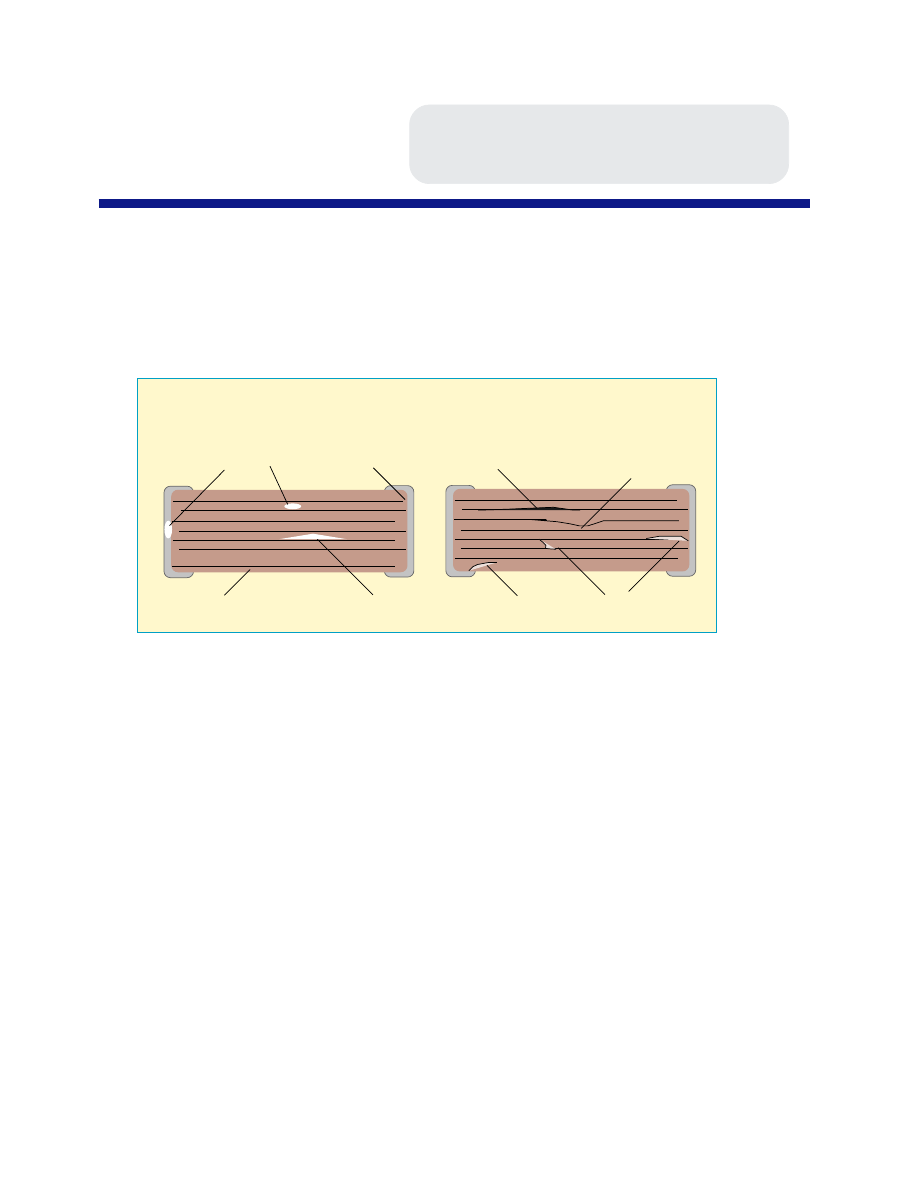
4
FIGURE N-2
MICROSTRUCTURE DEFECTS
thick electrode
stress crack
crack
irregular dielectric
thin cover
delamination
void
bubble
narrow margin
dielectric thickness.
Thick electrode depositions, exceeding 2.5 times the average electrode thickness, and ex-
tending over 50% of the electrode length.
Thick electrode deposition, extending over .005" (.127 mm), which also reduces the adja-
cent dielectric layer thickness by more than 30%.
Sample Preparation Defects
A variety of imperfections observed on sectioned specimens can arise due to the method of sample
preparation, and must be so identified, so as to preclude erroneous interpretation of results. Subtle
observations and precautions can be followed to positively segregate preparation problems from
actual defects. First, it is essential that the specimen be observed, prior to mounting in a section, to
determine if any obvious mechanical flaws are present. Usually this is accompanied by inspection of
basic electrical properties. Secondly, units must be rigidly encapsulated, with non-shrinking (and
hence stress-free) resin, and be ground and polished with fine grit abrasives under controlled pres-
sure, to avoid cracking. Sections must be polished to remove all vestiges of the rough cuts used to
reduce the specimen, and be cleaned thoroughly before observation. This procedure will minimize
the occurrence of most sectioning induced defects (depicted in Figure N-4).
The following criteria are used to attribute defects to sectioning methods:
Void defects form linear patterns
, i.e. they are induced by grit pulling material out of the
ceramic during grinding, hence more polishing is required. Note that voids forming a line
parallel to the layered structure of the device, a so called “knit line”, may not fall into this
category.
NOVACAP
TECHNICAL BROCHURE
tech_visual_standards-html.html

5
Large voids are present, with virtually no distortion of the electrode pattern or of adjacent
dielectric layers.
The correctness of the structure around these voids is indicative as to their
absence in the original unsectioned unit; thermal processing would otherwise result in col-
lapse of electrode and/ or distortion of layers around these voids. Such defects are caused by
excessive pullout during grinding, particularly in the area between electrode layers, where
there is minimal dielectric layer to layer bonding.
Units exhibit cover sheet cracks,
and/or separation of the ceramic cover sheet from the elec-
trode array, yet were not evident on usual examination of the device prior to sectioning. These
defects arise due to insufficient support in the encapsulant, and/or excessive grinding methods.
Such cracks may also appear parallel to the end terminations, as the termination to ceramic inter-
face is mechanically weaker; measurements of capacitance, DF and insulation resistance, as well
as termination pull strength can be used to confirm the absence of this defect in unsectioned prod-
uct.
Excessive polishing will round corners and edges of the section, resulting in depth of field
distortions on observation, as well as difficulty with illumination. ‘Defects’ which appear
under these conditions may be non existent and should be disregarded.
Evaluation of visual and microstructure quality of chip capacitors is very subjective, and difficulties
arise in correlating opinions between observers, especially when considering the minor category of
defects described above. In addition, dissimilar images can occur when viewing product under
differing light sources on a microscope. Fluorescent lighting has been found to be superior over
incandescent light in highlighting defects.
FIGURE N-4
SAMPLE PREPARATION DEFECTS
dielectric pull out
rounded corner -
excessive polishing
insufficient polish
cracks or chip outs
The acceptance or rejection of capacitors with any visual or microstructure defects is usually specified or
determined by the chip user, based on the application of the product. High reliability or high voltage units
must meet the stringiest standards.
NOVACAP
TECHNICAL BROCHURE